Zdroj:https://link.springer.com/chapter/10.1007/978-3-319-48933-9_13

Křemík, který bude a nadále bude po nějakou dobu dominantním materiálem v polovodičovém průmyslu [13.1], přenese nás do éry ultra velké integrace (ULSI) a éry systém-ona-čip (SOC).
Jak se elektronická zařízení staly pokročilejšími, výkon zařízení se stal citlivějším na kvalitu a vlastnosti materiálů použitých k jejich konstrukci.
Germanium (Ge) bylo původně používáno jako polovodičový materiál pro elektronická zařízení v pevné fázi. Úzký pásmo (0,66 eV) Ge však omezuje provoz zařízení na bázi germania na teploty přibližně 90∘C kvůli značným svodovým proudům pozorovaným při vyšších teplotách. Širší pásmo křemíku (1,12 eV) na druhé straně vede k tomu, že elektronická zařízení jsou schopna pracovat až. Existuje však mnohem závažnější problém než úzká pásmová propast: germánium neposkytuje na povrchu snadno astabilní pasivační vrstvu. Například oxid germaničitý (GeO2) je rozpustný ve vodě a disociuje přibližně při 800∘C. Křemík, na rozdíl od germania, snadno pojme povrchovou pasivaci vytvořením oxidu křemičitého (SiO2), který poskytuje vysoký stupeň ochrany podkladovému zařízení. Tento stabilní SiO2Výsledkem této vrstvy je rozhodující výhoda křemíku oproti germanu jako základního polovodičového materiálu používaného pro výrobu elektronických zařízení. Tato výhoda vedla k řadě nových technologií, včetně procesů pro difúzní doping a definování složitých vzorů. Další výhody křemíku spočívají v tom, že je zcela netoxický a že oxid křemičitý (SiO2), surovina, ze které se získává křemík, obsahuje přibližně 60%obsahu minerálů v zemské kůře. To znamená, že surovina, ze které se získává křemík, je k dispozici v dostatečném množství pro integrovaný obvod (IC) průmysl. Kromě toho lze elektronický křemík získat za méně než jednu desetinu nákladů na germanie. Všechny tyto výhody způsobily, že křemík téměř úplně nahradil germanie v polovodičovém průmyslu.
Ačkoli křemík není optimální volbou pro každé elektronické zařízení, jeho výhody znamenají, že téměř jistě po nějakou dobu téměř jistě ovládne polovodičový průmysl.
Velmi plodné interakce nastaly mezi uživateli a výrobci polovodičového materiálu od vynálezu tranzistoru s bodovým kontaktem v roce 1947, kdy byla nutnostdokonalé a čistékrystaly byly rozpoznány. Konkurence byla často taková, že kvalitu krystalů požadovanou novými zařízeními bylo možné uspokojit pouze kontrolou růstu krystalů pomocí elektronického zařízení vyrobeného s těmito novými zařízeními. Protože krystaly křemíku bez dislokace byly pěstovány již v 60. letech 20. století pomocíDash technika[13.2], výzkum polovodičových materiálů a vývojové úsilí se soustředily na čistotu materiálu, výtěžnost výroby a problémy spojené s výrobou zařízení. Vývojový diagram pro typické procesy přípravy polovodičového křemíku. (Po[13.1]) Čipy na destičku jako funkce generace paměti DRAM. (Po[13.3]) V této kapitole jsou uvedeny současné přístupy k přípravě křemíku - přeměna suroviny na monokrystalický křemík (viz obr.13.1) - jsou diskutovány. Dalším krokem je čištění MG-Si na úroveň polovodičového křemíku (SG-Si), který se používá jako výchozí materiál pro monokrystalický křemík. Základní koncepce spočívá v tom, že práškový MG-Si reaguje s bezvodým HC1 za vzniku různých chlorsilanových sloučenin v reaktoru s fluidním ložem. Poté se silany čistí destilací a chemickým vylučováním par (CVD) za vzniku SG-polykrystalického křemíku. 1. Může být snadno vytvořen reakcí bezvodého chlorovodíku s MG-Si při přiměřeně nízkých teplotách (200–400∘C). 2. Je kapalný při pokojové teplotě, takže čištění lze provést pomocí standardních destilačních technik. 3. Snadno se s ním manipuluje a lze jej skladovat v suchých nádržích z uhlíkové oceli. 4. Kapalný trichlorsilan se snadno odpařuje a po smíchání s vodíkem se může přepravovat v ocelových linkách. 5. Může být snížena za atmosférického tlaku v přítomnosti vodíku. 6. K jeho usazování může docházet na zahřátém křemíku, což eliminuje potřebu kontaktu s jakýmikoli cizími povrchy, které mohou kontaminovat výsledný křemík. 7. Reaguje při nižších teplotách (1 000–1 200∘C) a rychleji než chlorid křemičitý. Není nutné říkat, že čistota tenkých tyčí musí být srovnatelná s čistotou naneseného křemíku. Tenké tyče jsou předehřáté na přibližně 400∘C na začátku procesu křemíkového CVD. Toto předehřívání je nutné, aby se dostatečně zvýšila vodivost tenkých tyčí o vysoké čistotě (vysoké odolnosti), aby se umožnilo odporové zahřívání. Vklad na 200–300 h kolem 1100∘Výsledkem C jsou vysoce čisté polysilikonové tyče o průměru 150–200 mm. Polysilikonové tyče jsou tvarovány do různých forem pro následné procesy růstu krystalů, jako jsou kusy pro růst taveniny Czochralski a dlouhé válcové tyče pro růst v plovoucí zóně. Proces redukce trichlorsilanu na vyhřívané křemíkové tyči pomocí vodíku byl popsán na konci 50. a na počátku 60. let v řadě patentů na procesy přidělených společnosti Siemens; proto se tento proces často nazýváMetoda Siemens[13.4]. Hlavní nevýhody metody Siemens jsou její špatná účinnost přeměny křemíku a chloru, relativně malá velikost dávky a vysoká spotřeba energie. Špatná účinnost přeměny křemíku a chloru je spojena s velkým objemem chloridu křemičitého produkovaného jako vedlejší produkt v procesu CVD. Pouze asi 30%křemíku poskytovaného v CVD reakci se převede na vysoce čistý polykřemík. Také náklady na výrobu vysoce čistého polykrystalického křemíku mohou záviset na užitečnosti vedlejšího produktu, SiCl4. Technologie výroby apolysilikonu založená na výrobě a pyrolýze monosilanu byla zavedena koncem šedesátých let. Monosilan potenciálně šetří energii, protože ukládá polysilikon při nižší teplotě a produkuje čistší polysilikon než trichlorsilanový proces; těžko se však používá kvůli nedostatku ekonomické cesty k monosilanu a kvůli problémům se zpracováním v depozičním kroku [13.5]. S nedávným vývojem ekonomických cest k vysoce čistému silanu a úspěšným provozem zařízení v mimořádném měřítku však tato technologie upoutala pozornost polovodičového průmyslu, který vyžaduje silikon vyšší čistoty. V současných průmyslových monosilanových procesech se hořčík a prášek MG-Si zahřívají na 500 ° C∘C v atmosféře vodíku za účelem syntézy silicidu magnesia (Mg2Si), který se poté nechá reagovat s chloridem amonným (NH4Cl) v kapalném amoniaku (NH3) pod 0∘C za vzniku monosilanu (SiH4). Vysoce čistý polykrystalický křemík se poté vyrábí pyrolýzou monosilanu na odporově zahřívaných polysilikonových vláknech při 700–800∘C. V procesu generování monosilanu je většina nečistot boru odstraněna ze silanu chemickou reakcí s NH3. Obsahu aboronu 0,01–0,02 ppba v polykrystalickém křemíku bylo dosaženo použitím amonosilanového procesu. Tato koncentrace je velmi nízká ve srovnání s koncentrací pozorovanou u polysilikonu připraveného z trichlorsilanu. Navíc je výsledný polykrystalický křemík méně kontaminovaný kovy zachycenými chemickými transportními procesy, protože rozklad monosilanu nezpůsobuje žádné korozní problémy. Byl vyvinut významně odlišný proces, který využívá rozklad monosilanu v depozičním reaktoru s fluidním ložem k výrobě sypkého granulovaného polykrystalického křemíku [13.5]. Drobné částice křemíkových semen se fluidizují ve směsi vodíku s amonosilanem ∕ a polysilikon se ukládá za vzniku volně tekoucích sférických částic, které mají průměr v průměru 700 μm s distribucí velikosti 100–1500 μm. Semena s fluidním ložem byla původně vyrobena rozemletím SG-Si v Aball nebo kladivovém mlýně a vyluhováním produktu kyselinou, peroxidem vodíku a vodou. Tento proces byl časově náročný a nákladný a směřoval k zavádění nežádoucích nečistot do systému pomocí kovových drtičů. Avšak v nové metodě jsou velké částice SG-Si navzájem vypalovány vysokorychlostním proudem plynu, který způsobuje jejich rozpad na částice vhodné velikosti pro fluidní lože. Tento proces nezavádí žádné cizí materiály a nevyžaduje žádné loužení. Kvůli většímu povrchu granulovaného polykrystalického křemíku jsou reaktory s fluidním ložem mnohem účinnější než tradiční tyčové reaktory typu Siemens. Ukázalo se, že kvalita polykrystalického křemíku s fluidním ložem je ekvivalentní s polykrystalickým křemíkem vyráběným běžnější metodou společnosti Siemens. Granulovaný polykrystalický křemík volně tekoucí formy a vysoké objemové hmotnosti navíc umožňuje pěstitelům krystalů získat maximum z každé výrobní série. To znamená, že v procesu růstu krystalů Czochralski (viz následující část) lze kelímky rychle a snadno naplnit na rovnoměrné zatížení, které obvykle přesahuje hodnoty náhodně naskládaných polysilikonových bloků vyrobených metodou Siemens. Pokud vezmeme v úvahu také potenciál této techniky přejít od dávkového provozu k kontinuálnímu tažení (popsáno dále), můžeme vidět, že volně tekoucí polysilikonové granule by mohly poskytnout výhodnou cestu jednotného dávkování do taveniny v ustáleném stavu. Tento produkt se jeví jako revoluční výchozí materiál s velkým příslibem pro růst křemíkových krystalů. Principy růstu monokrystalů do (a) metoda s plovoucí zónou a (b) Czochralského metoda. (Po[13.1]) Odhaduje se, že asi 95%veškerý monokrystalický křemík se vyrábí metodou CZ a zbytek hlavně metodou FZ. Křemíkový polovodičový průmysl vyžaduje vysokou čistotu a minimální koncentrace defektů v jejich křemíkových krystalech, aby se optimalizoval výtěžek výroby zařízení a provozní výkon. Tyto požadavky jsou stále přísnější, protože se technologie mění z LSI na VLSI ∕ ULSI a poté na SOC. Kromě kvality nebo dokonalosti křemíkových krystalů se také neustále zvyšuje průměr krystalů, aby byly splněny požadavky výrobců zařízení. Protože mikroelektronické čipy jsou vyráběny prostřednictvím adávkový systém, průměry křemíkových destiček použitých pro výrobu zařízení významně ovlivňují produktivitu (jak je znázorněno na obr.13.2) a následně výrobní náklady. V následujících částech nejprve probereme metodu FZ a poté přejdeme k metodě CZ. Druhá bude podrobněji diskutována kvůli její extrémní důležitosti pro mikroelektronický průmysl. Metoda FZ vznikla zónovým tavením, které bylo použito k rafinaci binárních slitin [13.6] a byl vynalezenTheuerer[13.7]. Reaktivita kapalného křemíku s materiálem použitým pro kelímek vedla k vývoji metody FZ [13.8], který umožňuje krystalizaci křemíku bez nutnosti jakéhokoli kontaktu s materiálem kelímku, který je nezbytný pro schopnost pěstovat krystaly požadované polovodičové čistoty. V procesu FZ se apolysilikonová tyčinka přeměňuje na ingot s jedním krystaly průchodem amoltenové zóny ohřívané cívkou aneedle-eye z jednoho konce tyče na druhý, jak je znázorněno na obr.13.3A. Nejprve se špička polysilikonové tyče uvede do kontaktu a spojí se s nasazeným krystalem s požadovanou orientací krystalu. Tento proces se nazývásetí. Naočkovaná roztavená zóna prochází polysilikonovou tyčí současným pohybem monokrystalického semene dolů po tyči. Když roztavená zóna křemíku ztuhne, polysilikon se pomocí očkovacího krystalu přemění na monokrystalický křemík. Jak se zóna pohybuje podél polysilikonové tyče, monokrystalický křemík na svém konci zmrzne a roste jako prodloužení očkovacího krystalu. Rentgenová topografie semen, krku a kónické části křemíku s plovoucí zónou. (Se svolením Dr. T. Abeho) Nosný systém pro křemíkový krystal s plovoucí zónou. (Po[13.9]) Aby se získaly monokrystaly křemíku typu n nebo p s požadovaným měrným odporem, musí být polysilikon nebo rostoucí krystal dotován příslušnými nečistotami donoru nebo akceptoru. Pro růst FZ křemíku, i když bylo vyzkoušeno několik dopingových technik, jsou krystaly typicky dopovány foukáním adoptivního plynu, jako je fosfin (PH3) pro křemík nebo diboran typu N (B2H6) pro křemík typu p na roztavenou zónu. Dopantový plyn je obvykle zředěn nosným plynem, jako je argon. Velkou výhodou této metody je, že výrobce křemíkových krystalů nemusí skladovat zdroje křemíku s různým odporem. Aplikace NTD byla téměř výlučně omezena na krystaly FZ kvůli jejich vyšší čistotě ve srovnání s krystaly CZ. Když byla technika NTD použita na krystaly křemíku CZ, bylo zjištěno, že tvorba dárce kyslíku během procesu žíhání po ozáření změnila odpor z očekávaného, přestože byla dosažena homogenita dárce fosforu [13.11]. NTD má další nedostatek, že pro dopanty typu p není k dispozici žádný proces a že je vyžadována příliš dlouhá doba ozařování pro nízký odpor (v rozmezí 1–10 Ω cm). Během růstu krystalů FZ nedojde roztavený křemík do kontaktu s žádnou jinou látkou než s okolním plynem v růstové komoře. Proto se křemíkový krystal FZ neodmyslitelně vyznačuje vyšší čistotou ve srovnání s krystalem aCZ, který se pěstuje z taveniny - zahrnuje kontakt s aquartzovým kelímkem. Tento kontakt vede k vysokým koncentracím nečistot kyslíku kolem 1018atomy ∕ cm3v CZ krystalech, zatímco FZ křemík obsahuje méně než 1016atomy ∕ cm3. Tato vyšší čistota umožňuje FZ křemíku dosáhnout vysokých měrných odporů, které nelze dosáhnout použitím CZ křemíku. Většina spotřebovaného křemíku FZ má arezistivitu mezi 10 a 200 Ω cm, zatímco křemík CZ je obvykle připraven na měrný odpor 50 Ω cm nebo méně kvůli kontaminaci z křemenného kelímku. FZ křemík se proto používá hlavně k výrobě polovodičových výkonových zařízení, která podporují zpětné napětí vyšší než 750–1000 V. Vysoký růst krystalů a přesné dopingové vlastnosti NTD FZ-Si také vedly k jeho použití v infračervených detektorech [13.12], například. Pokud však vezmeme v úvahu mechanickou pevnost, již mnoho let se uznává, že křemík FZ, který obsahuje méně nečistot kyslíku než křemík CZ, je mechanicky slabší a náchylnější k tepelnému namáhání během výroby zařízení [13.13,13.14]. Vysokoteplotní zpracování křemíkových destiček během výroby elektronických zařízení často produkuje dostatečné tepelné namáhání, aby generovalo vyklouznutí a deformaci skluzu. Tyto efekty způsobují ztrátu výtěžku v důsledku netěsných spojů, dielektrických vad a snížené životnosti, stejně jako snížené fotolitografické výtěžky v důsledku degradace rovinnosti destičky. Ztráta geometrické rovinnosti způsobená pokřivením může být tak závažná, že destičky nejsou dále zpracovávány. Z tohoto důvodu se křemíkové destičky CZ používají při výrobě zařízení IC mnohem častěji než destičky FZ. Tento rozdíl v mechanické stabilitě proti tepelnému namáhání je dominantním důvodem, proč se krystaly křemíku CZ používají výhradně k výrobě integrovaných obvodů, které vyžadují alarmující počet kroků tepelného procesu. Aby bylo možné překonat tyto nedostatky křemíku FZ, růst krystalů křemíku FZ s dopingovými nečistotami, jako je kyslík [13.15] a dusík [13.16] byl proveden pokus. Bylo zjištěno, že dopování FZ křemíkových krystalů kyslíkem nebo dusíkem v koncentracíchnebomá za následek pozoruhodné zvýšení mechanické pevnosti. Tato metoda byla pojmenována po J. Czochralskim, který zavedl techniku pro stanovení rychlostí krystalizace kovů [13.17]. Avšak skutečná metoda tahání, která byla široce používána pro růst monokrystalů, byla vyvinutaŠedozelenáaMálo[13.18], který upravil Czochralského základní princip. Jako první v roce 1950 úspěšně pěstovali monokrystaly germania o délce 8 palců a průměru 0,75 palce. Následně navrhli další zařízení pro růst křemíku při vyšších teplotách. Ačkoli se základní výrobní proces monokrystalického křemíku od doby, kdy byl průkopníkem společnosti Teal a spolupracovníky, změnil jen málo, silikonové monokrystaly s velkým průměrem (až 400 mm) s vysokou mírou dokonalosti splňují nejmodernější zařízení požadavky vzrostly začleněním techniky Dash a postupných technologických inovací do přístroje. Dnešní úsilí v oblasti výzkumu a vývoje týkající se křemíkových krystalů je zaměřeno na dosažení mikroskopické uniformity vlastností krystalů, jako je měrný odpor a koncentrace nečistot a mikrodefektů, jakož i na jejich mikroskopickou kontrolu, o níž bude pojednáno jinde v této příručce. 1. Polysilikonové kousky nebo zrna se umístí do aquartzového kelímku a roztaví se při teplotách vyšších, než je teplota tání křemíku (1420∘C) v inertním okolním plynu. 2. Tavenina se po určitou dobu udržuje při vysoké teplotě, aby se zajistilo úplné roztavení a vytlačování drobných bublin z taveniny, které by mohly způsobit dutiny nebo negativní defekty krystalů. 3. Aseed krystal s požadovanou orientací krystalu je ponořen do taveniny, dokud se nezačne tavit sám. Osivo se potom odtahuje z taveniny, takže se hrdlo vytváří postupným zmenšováním průměru; toto je nejchoulostivější krok. Během celého procesu růstu krystalů proudí inertní plyn (obvykle argon) dolů tažnou komorou, aby odvedl reakční produkty, jako je SiO a CO. 4. Postupným zvětšováním průměru krystalu rostou kónická část a rameno. Průměr se zvětšuje až k cílovému průměru snížením rychlosti tažení a ∕ nebo teploty taveniny. 5. Nakonec se válcová část tělesa se stálým průměrem pěstuje řízením rychlosti tažení a teploty taveniny, přičemž se kompenzuje pokles hladiny taveniny při růstu krystalu. Rychlost tažení je obecně snížena směrem k zadnímu konci dorůstajícího krystalu, hlavně kvůli zvyšujícímu se tepelnému záření ze stěny kelímku při poklesu hladiny taveniny a vystavení stěny kelímku rostoucímu krystalu. Ke konci růstového procesu, ale předtím, než je kelímek úplně vypuštěn z roztaveného křemíku, musí být průměr krystalu postupně zmenšen, aby se vytvořil koncový kužel, aby se minimalizoval tepelný šok, který může způsobit vyklouznutí na konci. Když je průměr dostatečně malý, lze krystal oddělit od taveniny bez vytváření dislokací. Schematický pohled na typický systém pěstování krystalů křemíku Czochralski. (Po[13.1]) Koncová část vzrostlého Czochralského křemíkového krystalu Mimořádně velký pěstovaný Czochralského křemíkový ingot o průměru 400 mm a délce 1800 mm. (Se svolením Super Silicon Crystal Research Institute Corporation, Japonsko) Tepelné prostředí během růstu Czochralského krystalů v počáteční a konečné fázi.Šipkyoznačte přibližné směry tepelného toku. (Po[13.19]) Rovněž dochází k anuniformní distribuci jak defektů krystalů, tak nečistot v příčném řezu ploché destičky připravené z aCZ krystalické křemíkové taveniny krystalizované nebo ztuhlé postupně na rozhraní krystal-tavenina, které je obecně zakřiveno v procesu růstu krystalů CZ. Takové nehomogenity lze pozorovat jakopruhování, o nichž se pojednává později. Vlastnosti křemíkových polovodičů používaných v elektronických zařízeních jsou velmi citlivé na nečistoty. Díky této citlivosti lze elektrické ∕ elektronické vlastnosti křemíku přesně řídit přidáním malého množství dopantu. Kromě této citlivosti na příměsi, kontaminace nečistotami (zejména přechodnými kovy) negativně ovlivňuje vlastnosti křemíku a vede k vážnému zhoršení výkonu zařízení. Kromě toho je kyslík inkorporován v množství desítek atomů na milion do krystalů křemíku CZ v důsledku reakce mezi taveninou křemíku a křemenným kelímkem. Bez ohledu na to, kolik kyslíku je v krystalu, jsou vlastnosti křemíkových krystalů velmi ovlivněny koncentrací a chováním kyslíku [13.21]. Kromě toho je uhlík také zabudován do CZ křemíkových krystalů buď z polysilikonových surovin, nebo během procesu růstu, a to díky grafitovým částem použitým v tažném zařízení CZ. Ačkoli je koncentrace uhlíku v komerčních krystalech křemíku CZ obvykle nižší než 0,1 ppma, uhlík je nečistota, která výrazně ovlivňuje chování kyslíku [13.22,13.23]. Také krystaly křemíku CZ dotované dusíkem [13.24,13.25] v poslední době přitahují velkou pozornost díky své vysoké mikroskopické kvalitě krystalů, která může splňovat požadavky na nejmodernější elektronická zařízení [13.26,13.27]. Během krystalizace z taveniny se do rostoucího krystalu začleňují různé nečistoty (včetně příměsí) obsažené v tavenině. Koncentrace nečistot v pevné fázi se obecně liší od koncentrace v kapalné fázi v důsledku aphenomenonu známého jakosegregace. Rovnovážné segregační chování spojené s tuhnutím vícesložkových systémů lze určit z příslušného fázového diagramu binárního systému srozpuštěná látka(nečistota) a asolventní(hostitelský materiál) jako komponenty. Je tedy zřejmé, že amakroskopická podélná změna úrovně nečistoty, která způsobí letectví v měrném odporu v důsledku změn v koncentraci dopantu, je vlastní procesu růstu šarže CZ; je to způsobeno jevem segregace. Kromě toho je podélná distribuce nečistot ovlivněna změnami velikosti a povahy konvekce taveniny, ke které dochází, když se během růstu krystalů snižuje poměr stran taveniny. Růstové pruhování, odhalené chemickým leptáním, v rameni Czochralského křemíku Řezy jsou fyzicky způsobeny oddělováním nečistot a také bodových vad; avšak pruhování je prakticky způsobeno teplotními výkyvy poblíž rozhraní krystal-tavenina, vyvolanými nestabilní tepelnou konvekcí v tavenině a rotací krystalů v asymetrickém tepelném prostředí. Kromě toho mohou mechanické výkyvy způsobené špatnými mechanismy tažení v růstovém zařízení také způsobit kolísání teploty. Schematické znázornění průřezu Czochralského krystalu obsahujícího zaoblené rozhraní krystal-tavenina a rovinné destičky nakrájené na různé části. (Po[13.1]) Aby se získal požadovaný měrný odpor, přidá se určité množství dopantu (atomy donoru nebo akceptoru) do taveniny křemíku podle vztahu odpor - koncentrace. Je běžnou praxí přidávat příměsi ve formě vysoce dotovaných křemíkových částic nebo kusů s měrným odporem asi 0,01 Ω cm, které se nazývají příměsové přísady, protože množství čistého dopantu je nespravedlivě malé, s výjimkou silně dotovaných křemíkových materiálů (n+nebo str+křemík). 1. Vhodné energetické úrovně 2. Vysoká rozpustnost 3. Vhodná nebo nízká difuzivita 4. Nízký tlak par. Začlenění kyslíku a uhlíku do Czochralského křemíkového krystalu. (Po[13.1]) 1. Velký průměr 2. Nízká nebo kontrolovaná hustota defektů 3. Rovnoměrný a nízký gradient radiálního odporu 4. Optimální počáteční koncentrace kyslíku a jeho srážení. Konvekční tok taveniny v kelímku silně ovlivňuje kvalitu krystalů CZ křemíku. Zejména jsou nepříznivé růstové proudy indukovány nestabilní konvekcí taveniny, která vede k teplotním výkyvům na růstovém rozhraní. Schopnost amagnetického pole inhibovat tepelnou konvekci v elektricky vodivé tekutině byla nejprve aplikována na růst krystalů antimonidu india pomocí techniky horizontálního člunu [13.28] a technika tání horizontální zóny [13.29]. Prostřednictvím těchto výzkumů bylo potvrzeno, že amagnetické pole dostatečné síly může potlačit teplotní výkyvy, které doprovázejí konvekci taveniny, a může dramaticky snížit růstové pruhování. Vliv magnetického pole na růstové pruhování lze vysvětlit jeho schopností snížit turbulentní tepelnou konvekci ameltu a následně snížit teplotní výkyvy na rozhraní krystal-tavenina. Tlumení toku tekutiny způsobené magnetickým polem je způsobeno indukovanou magnetomotorickou silou, když je tok kolmý k čarám magnetického toku, což má za následek zvýšení účinné kinematické viskozity vodivé taveniny. Růst křemíkových krystalů metodou CZ (MCZ) aplikovanou magnetickým polem byl poprvé zaznamenán v roce 1980 [13.30]. Původně byl MCZ určen pro růst krystalů křemíku CZ, které obsahují nízké koncentrace kyslíku, a proto mají vysoký odpor s malými radiálními změnami. Jinými slovy se očekávalo, že křemík MCZ nahradí křemík FZ téměř výhradně používaný pro výrobu výkonových zařízení. Od té doby byly vyvinuty různé konfigurace magnetického pole, pokud jde o směr magnetického pole (horizontální nebo vertikální) a typ použitých magnetů (normální vodivé nebo supravodivé) [13.31]. Křemík MCZ vyráběný v širokém rozsahu požadovaných koncentrací kyslíku (od nízké po vysokou) má velký zájem pro různé aplikace zařízení. Hodnota křemíku MCZ spočívá v jeho vysoké kvalitě a schopnosti řídit koncentraci kyslíku v širokém rozmezí, čehož nelze dosáhnout konvenční metodou CZ [13.32], stejně jako jeho zvýšená rychlost růstu [13.33]. Pokud jde o kvalitu krystalů, není pochyb o tom, že metoda MCZ poskytuje křemíkové krystaly nejvýhodnější pro průmysl polovodičových součástek. Výrobní náklady na křemík MCZ mohou být vyšší než u běžného křemíku CZ, protože metoda MCZ spotřebovává více elektrické energie a vyžaduje další vybavení a provozní prostor pro elektromagnety; avšak s přihlédnutím k vyšší rychlosti růstu MCZ a při použití supravodivých magnetů, které vyžadují menší prostor a spotřebovávají méně elektrické energie ve srovnání s vodivými magnety, mohou být výrobní náklady křemíkových krystalů MCZ srovnatelné s náklady běžných CZ křemíkových krystalů. Kromě toho může vylepšená kvalita krystalů křemíku MCZ zvýšit výtěžnost výroby a snížit výrobní náklady. Náklady na výrobu krystalů závisí do značné míry na nákladech na materiály, zejména na nákladech použitých pro křemenné kelímky. V konvenčním procesu CZ, zvaném adávkový proces, je krystal vytažen z jednorázové náplně kelímku a křemenný kelímek je použit pouze jednou a poté je vyřazen. Je to proto, že malé množství zbývajícího křemíku praskne kelímek, jak se ochlazuje z vysoké teploty během každého růstu. Onestrategie pro ekonomické doplňování aquartzového kelímku tavením je kontinuální přidávání krmiva při růstu krystalů a tím udržování taveniny na stálém objemu. Kromě úspory nákladů na kelímek poskytuje metoda Czochralski (CCZ) s kontinuálním nabíjením ideální prostředí pro růst křemíkových krystalů. Jak již bylo zmíněno, mnoho nehomogenit v krystalech pěstovaných konvenčním dávkovým procesem CZ je přímým výsledkem nestabilní kinetiky vznikající ze změny objemu taveniny během růstu krystalů. Cílem metody CCZ je nejen snížit výrobní náklady, ale také pěstovat krystaly za stabilních podmínek. Udržováním objemu taveniny na konstantní úrovni lze dosáhnout stabilních tepelných podmínek a podmínek toku taveniny (viz obr.13.9, což ukazuje změnu tepelného prostředí během růstu konvenční CZ). Schematické znázornění Czochralského metody kontinuálního nabíjení. (Po[13.34]) Metoda CCZ rozhodně řeší většinu problémů souvisejících s nehomogenitami v krystalu pěstovaném konvenční metodou CZ. Navíc kombinace MCZ a CCZ (spojitá CZ aplikovaná magnetickým polem (MCCZ) metoda) se očekává, že poskytne konečnou metodu růstu krystalů, která poskytne ideální křemíkové krystaly pro širokou škálu mikroelektronických aplikací [13.1]. Ve skutečnosti se používá k pěstování vysoce kvalitních křemíkových krystalů určených pro mikroelektronická zařízení [13.35]. Je však třeba zdůraznit, že rozdílné teplotní historie různých částí krystalu (od semene po konce ocasu, jak je znázorněno na obr.13.9) je třeba vzít v úvahu, i když se krystal pěstuje ideální metodou růstu. Za účelem homogenizace pěstovaného krystalu nebo k dosažení axiální rovnoměrnosti v tepelné historii, je třeba provést nějakou formu následného zpracování, jako je vysokoteplotní žíhání [13.36], je vyžadován pro krystal. Jak již bylo zmíněno dříve, Dashův postup zúžení (který roste kolem krku o průměru 3–5 mm, obr.13.7) je kritickým krokem během růstu krystalů CZ, protože eliminuje narůstající dislokace. Tato technika je průmyslovým standardem již více než 40 let. Nedávné požadavky na velké průměry krystalů (&> 300 mm, vážící přes 300 kg) však vedly k potřebě krčků s větším průměrem, které nezavádějí dislokace do rostoucího krystalu, protože atinový krk o průměru 3–5 mm nemůže podporovat takové velké krystaly. Czochralského křemíkový krystal o průměru 200 mm bez dislokace vypěstovaný bez procesu zúžení Dash. (a)Celé tělo, (b) osivo a kužel. (Se svolením prof. K. Hoshikawy) 13.1F. Shimura:Technologie polovodičových křemíkových krystalů(Academic, New York 1988)Google Scholar 13.2WC Dash: J. Appl. Phys.29, 736 (1958)CrossRefGoogle Scholar 13,3 tis. Takada, H. Yamagishi, H. Minami, M. Imai: In:Polovodičový křemík(The Electrochemical Society, Pennington 1998) str. 376Google Scholar 13.4JRMcCormic: V:Polovodičový křemík(The Electrochemical Society, Pennington 1986) str.43Google Scholar 13.5PA Taylor: Solid State Technol.červenec, 53 (1987)Google Scholar 13,6 WG Pfann: Trans. Dopoledne. Inst. Min. Metall. Eng.194, 747 (1952)Google Scholar 13.7CH Theuerer: US Patent 3060123 (1962)Google Scholar 13,8 PH Keck, MJE Golay: Fyz. Rev.89, 1297 (1953)CrossRefGoogle Scholar 13,9 W. Keller, A. Mühlbauer:Křemík v plovoucí zóně(Marcel Dekker, New York 1981)Google Scholar 13.10 JM Meese:Transmutace neutronů Doping v polovodičích(Plenum, New York 1979)CrossRefGoogle Scholar 13.11HMLiaw, CJVarker: V:Polovodičový křemík(The Electrochemical Society, Pennington 1977) str.116Google Scholar 13.12 ELKern, LSYaggy, JABarker: V:Polovodičový křemík(The Electrochemical Society, Pennington 1977) str.52Google Scholar 13,13 SM Hu: Appl. Phys. Lett.31, 53 (1977)CrossRefGoogle Scholar 13,14 tis. Sumino, H. Harada, I. Yonenaga: Jpn. J. Appl. Phys.19, L49 (1980)CrossRefGoogle Scholar 13,15 tis. Sumino, I. Yonenaga, A. Yusa: Jpn. J. Appl. Phys.19, L763 (1980)CrossRefGoogle Scholar 13.16T.Abe, K.Kikuchi, S.Shirai: V:Polovodičový křemík(Electrochemical Society, Pennington 1981) s. 54Google Scholar 13,17 J. Czochralski: Z. Phys. Chem.92, 219 (1918)Google Scholar 13,18 GK Teal, JB Little: Phys. Rev.78, 647 (1950)Google Scholar 13,19 W. Zulehner, D. Huber: V:Krystaly 8: křemík, chemické leptání(Springer, Berlin, Heidelberg 1982) str. 1Google Scholar 13.20H. Tsuya, F. Shimura, K. Ogawa, T. Kawamura: J. Electrochem. Soc.129, 374 (1982)CrossRefGoogle Scholar 13.21F. Shimura (ed.):Kyslík v křemíku(Academic, New York 1994)Google Scholar 13,22S. Kishino, Y. Matsushita, M. Kanamori: Appl. Phys. Lett.35, 213 (1979)CrossRefGoogle Scholar 13.23F. Shimura: J. Appl. Phys.59, 3251 (1986)CrossRefGoogle Scholar 13,24 HD Chiou, J. Moody, R. Sandfort, F. Shimura: Vědecká technologie VLSI, Proc. 2. int. Symp. Integrace ve velkém měřítku. (The Electrochemical Society, Pennington 1984) str. 208Google Scholar 13,25 F. Shimura, RS Hocket: Appl. Phys. Lett.48, 224 (1986)CrossRefGoogle Scholar 13.26A.Huber, M.Kapser, J.Grabmeier, U.Lambert, WvAmmon, R.Pech: In:Polovodičový křemík(The Electrochemical Society, Pennington 2002) str.280Google Scholar 13.27GARozgonyi: V:Polovodičový křemík(The Electrochemical Society, Pennington 2002) str.149Google Scholar 13,28 HP Utech, MC Flemings: J. Appl. Phys.37, 2021 (1966)CrossRefGoogle Scholar 13.29HA Chedzey, DT Hurtle: Nature210, 933 (1966)CrossRefGoogle Scholar 13:30 K. Hoshi, T. Suzuki, Y. Okubo, N. Isawa: Ext. Abstr. Elektrochem. Soc. 157. setkání. (Electrochemical Society, Pennington 1980) s. 811Google Scholar 13,31 M.Ohwa, T.Higuchi, E.Toji, M.Watanabe, K.Homma, S.Takasu: In:Polovodičový křemík(The Electrochemical Society, Pennington 1986) str.117Google Scholar 13,32 M. Futagami, K. Hoshi, N. Isawa, T. Suzuki, Y. Okubo, Y. Kato, Y. Okamoto: V:Polovodičový křemík(The Electrochemical Society, Pennington 1986) str. 939Google Scholar 13.33T. Suzuki, N.Isawa, K.Hoshi, Y. Kato, Y. Okubo: V:Polovodičový křemík(The Electrochemical Society, Pennington 1986) str.142Google Scholar 13,34 W. Zulehner: V:Polovodičový křemík(The Electrochemical Society, Pennington 1990) str.30Google Scholar 13.35 Y. Arai, M. Kida, N.Ono, K.Abe, N.Machida, H.Futuya, K.Sahira: In:Polovodičový křemík(The Electrochemical Society, Pennington 1994) str.180Google Scholar 13,36 F. Shimura: V:Věda a technologie VLSI(The Electrochemical Society, Pennington 1982) str. 17Google Scholar 13.37S. Chandrasekhar, KMKim: V:Polovodičový křemík(The Electrochemical Society, Pennington 1998) s. 411Google Scholar 13,38 tis. Hoshikawa, X. Huang, T. Taishi, T. Kajigaya, T. Iino: Jpn. J. Appl. Phys.38, L1369 (1999)CrossRefGoogle Scholar 13,39 km Kim, P. Smetana: J. Cryst. Růst100, 527 (1989)CrossRefGoogle Scholar13.1Přehled


13.2Výchozí materiály
13.2.1Křemík metalurgického stupně
Výchozím materiálem pro vysoce čisté monokrystaly křemíku je oxid křemičitý (SiO2). Prvním krokem při výrobě křemíku je tavení a redukce oxidu křemičitého. Toho je dosaženo smícháním oxidu křemičitého a uhlíku ve formě uhlí, koksu nebo dřevní štěpky a zahřátím směsi na vysoké teploty v ponorné elektrodové obloukové peci. Tato karbotermická redukce oxidu křemičitého produkuje kondenzovaný křemík13.2.2Polykrystalický křemík
Meziproduktové chemické sloučeniny
Hydrochlorace křemíku
Trichlorsilan se syntetizuje zahříváním práškového MG-Si na přibližně 300∘C v reaktoru s fluidním ložem. To znamená, že MG-Si se převádí na SiHCl3podle následující reakceDestilace a rozklad trichlorsilanu
K čištění trichlorsilanu se široce používá destilace. Trichlorsilan, který má nízkou teplotu varu (31.8∘C), je frakčně destilován z nečistých halogenidů, což má za následek značně zvýšenou čistotu, s elektricky aktivní koncentrací nečistot méně než 1 ppba. Vysoce čistý trichlorsilan se poté odpaří, zředí se vysoce čistým vodíkem a zavede se do depozičního reaktoru. V reaktoru jsou k dispozici tenké křemíkové tyče zvané tenké tyče podporované grafitovými elektrodami pro povrchovou depozici křemíku podle reakceMonosilanový proces
Granulované ukládání křemíku
13.3Jednokrystalický růst
Přestože byly k převodu polysilikonu na monokrystaly křemíku použity různé techniky, při jejich výrobě pro elektroniku dominovaly dvě techniky, protože splňují požadavky průmyslu mikroelektronických zařízení. Jedním z nich je metoda tavení azonu, která se běžně nazýváplovoucí zóna (FZ) metodaa druhým je apulling metoda tradičně nazývanáCzochralski (CZ) metoda, i když by se to vlastně mělo jmenovatModrozelená - malá metoda. Principy těchto dvou metod růstu krystalů jsou znázorněny na obr.13.3. V metodě FZ prochází amoltenová zóna apolysilikonovou tyčí, aby se přeměnila na ingot s jedním krystalem; v metodě CZ se jeden krystal pěstuje tahem z ameltu obsaženého v aquartzovém kelímku. V obou případechsemenný krystalhraje velmi důležitou roli při získávání jediného krystalu s požadovanou krystalografickou orientací.
13.3.1Metoda plovoucí zóny
Obecné poznámky
Nástin procesu

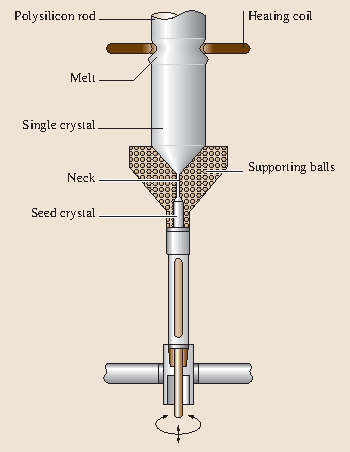
Doping
Vlastnosti FZ-křemíkového krystalu
13.3.2Czochralského metoda
Obecné poznámky
Nástin procesu
Tři nejdůležitější kroky v růstu CZ krystalů jsou schematicky znázorněny na obr.13.3b. Proces růstu CZ je v zásadě podobný procesu růstu FZ: (1) tavení polysilikonu, (2) očkování a (3) pěstování. Postup tahání CZ je však komplikovanější než postup růstu FZ a odlišuje se od něj použitím aquartzového kelímku k zadržení roztaveného křemíku. Postava13.6ukazuje aschemický pohled na typické moderní zařízení pro růst krystalů CZ. Důležité kroky ve skutečné nebo standardní sekvenci růstu křemíkových krystalů CZ jsou následující:
Postava13.7ukazuje koncovou část vypěstovaného křemíkového krystalu CZ. Ačkoliv je kukuřice aseed, která je přechodovou oblastí od semene k válcové části, obvykle z ekonomických důvodů vytvořena jako poměrně plochá, může být z hlediska kvality krystalu žádoucí zúžený tvar. Ramenní část a její okolí by neměly být používány pro výrobu zařízení, protože tato část je v mnoha smyslech považována za přechodovou oblast a vykazuje nehomogenní krystalové vlastnosti v důsledku náhlé změny podmínek růstu.


Vliv prostorového umístění inaGrownCrystal
Jak ukazuje obr.13.9jasně ukazuje, že každá část krystalu aCZ je pěstována v jiném čase s různými růstovými podmínkami [13.19]. Je tedy důležité si uvědomit, že každá část má odlišnou sadu charakteristik krystalů a jinou tepelnou historii díky své odlišné poloze podél délky krystalu. Například část konce semen má podélnou tepelnou historii, která se pohybuje od bodu tání 1420 do přibližně 400∘C v apulleru, zatímco koncová část má ashorterní historii a je ochlazována poměrně rychle z bodu tání. Nakonec každá křemíková destička připravená z jiné části zvětšeného krystalu mohla vykazovat různé fyzikálně-chemické vlastnosti v závislosti na jeho umístění v ingotu. Ve skutečnosti bylo hlášeno, že chování při srážení kyslíkem vykazuje největší závislost na poloze, což zase ovlivňuje generování hromadných defektů [13.20].
13.3.3Nečistoty v Czochralski Silicon
Nehomogenita nečistoty
Segregace
Striations
Ve většině procesů růstu krystalů existují přechodné parametry, jako je okamžitá rychlost mikroskopického růstu a tloušťka difuzní mezní vrstvy, které vedou ke změnám v účinném segregačním koeficientukeff. Tyto variace vedou k mikroskopickým kompozičním nehomogenitám ve forměpruhováníparalelně s rozhraním krystal-tavenina. Řasy lze snadno vymezit několika technikami, jako je preferenční chemické leptání a rentgenová topografie. Postava13.10ukazuje pruhy odhalené chemickým leptáním v ramenní části podélného řezu křemíkovým krystalem aCZ. Rovněž je jasně pozorována postupná změna tvaru růstového rozhraní.

Doping
Vysoká difuzivita nebo vysoký tlak par vede k nežádoucí difúzi nebo odpařování dopantů, což má za následek nestabilní provoz zařízení a potíže s dosažením přesné kontroly odporu. Příliš malá rozpustnost omezuje odpor, kterého lze dosáhnout. Kromě těchto kritérií je třeba vzít v úvahu chemické vlastnosti (například toxicitu). Další úvaha z hlediska růstu krystalů spočívá v tom, že dopant má asegregační koeficient, který je blízký jednotce, aby byl odpor co nejrovnoměrnější od zárodku ke konci CZ ingotů krystalů. V důsledku toho jsou fosfor (P) a bór (B) nejčastěji používanými donory a akceptory pro křemík. Pro n+křemík, ve kterém jsou donorové atomy silně dotovány, se místo fosforu obvykle používá antimon (Sb) kvůli jeho menší difuzivitě, navzdory malému koeficientu segregace a vysokému tlaku par, což vede k velkým odchylkám v koncentraci jak v axiálním, tak v radiální směry.Kyslík a uhlík
Jak je schematicky znázorněno na obr.13.3b a13.6, aquartz (SiO2) v metodě růstu krystalů CZ-Si se používají topné kelímky a grafit. Povrch kelímku, který se dotýká taveniny křemíku, se v důsledku reakce postupně rozpouští
13.4Nové metody růstu krystalů
Křemíkové krystaly používané pro výrobu mikroelektronických zařízení musí splňovat nejrůznější požadavky stanovené výrobci zařízení. Kromě požadavků na křemíkoplatky, následující krystalografické požadavky se staly běžnějšími díky výrobě vysoce výkonných a vysoce výkonných mikroelektronických zařízení:
Je zřejmé, že výrobci křemíkových krystalů musí nejen splňovat výše uvedené požadavky, ale také tyto krystaly vyrábět ekonomicky a s vysokými výtěžky výroby. Hlavní obavy pěstitelů křemíkových krystalů jsou krystalografická dokonalost a axiální distribuce dopantů v CZ křemíku. Za účelem překonání některých problémů s konvenční metodou růstu krystalů CZ bylo vyvinuto několik nových metod růstu krystalů.13.4.1Czochralského růst pomocíAppliedMagneticField (MCZ)
13.4.2Kontinuální Czochralského metoda (CCZ)

13.4.3Neckingless metoda růstu

Reference

















